复旦大学通信科学与工程系和电磁波信息科学教育部重点实验室,上海 200433
提出了一种基于光学外调制器倍频产生W波段线性调频(LFM)信号并用于高分辨率测距的新方案。通过光调制器将来自任意波形发生器(AWG)的LFM信号调制到光载波的边带上,利用光电探测器(PD)拍频完成光电转换,从而产生四倍频W波段LFM信号,其中心频率与带宽均为原始LFM信号的四倍。发射上述宽带LFM信号对相距为50 cm的2个目标分别测距,测量结果为48.8 cm,误差为1.2 cm。为进一步验证实验的可靠性,调整2个目标的距离为40 cm,测量结果为38.9 cm,误差为1.1 cm。该系统克服了难以直接在电域产生高频信号的“电子瓶颈”,通过光子辅助产生宽带LFM信号实现了高分辨率感知测距,为未来超高分辨率的线性调频连续波雷达系统提供了一种解决方案。
微波光子学 雷达测距 光子辅助倍频 线性调频连续波 W波段 激光与光电子学进展
2024, 61(9): 0906006

Author Affiliations
Abstract
National Key Laboratory of Solid-State Microwave Devices and Circuits, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
In this letter, high power density AlGaN/GaN high electron-mobility transistors (HEMTs) on a freestanding GaN substrate are reported. An asymmetric Γ-shaped 500-nm gate with a field plate of 650 nm is introduced to improve microwave power performance. The breakdown voltage (BV) is increased to more than 200 V for the fabricated device with gate-to-source and gate-to-drain distances of 1.08 and 2.92 μm. A record continuous-wave power density of 11.2 W/mm@10 GHz is realized with a drain bias of 70 V. The maximum oscillation frequency (fmax) and unity current gain cut-off frequency (ft) of the AlGaN/GaN HEMTs exceed 30 and 20 GHz, respectively. The results demonstrate the potential of AlGaN/GaN HEMTs on free-standing GaN substrates for microwave power applications.
freestanding GaN substrates AlGaN/GaN HEMTs continuous-wave power density breakdown voltage Γ-shaped gate Journal of Semiconductors
2024, 45(1): 012501

Author Affiliations
Abstract
National Key Laboratory of Application Specific Integrated Circuit (ASIC), Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
This work demonstrates high-performance NiO/β-Ga2O3 vertical heterojunction diodes (HJDs) with double-layer junction termination extension (DL-JTE) consisting of two p-typed NiO layers with varied lengths. The bottom 60-nm p-NiO layer fully covers the β-Ga2O3 wafer, while the geometry of the upper 60-nm p-NiO layer is 10 μm larger than the square anode electrode. Compared with a single-layer JTE, the electric field concentration is inhibited by double-layer JTE structure effectively, resulting in the breakdown voltage being improved from 2020 to 2830 V. Moreover, double p-typed NiO layers allow more holes into the Ga2O3 drift layer to reduce drift resistance. The specific on-resistance is reduced from 1.93 to 1.34 mΩ·cm2. The device with DL-JTE shows a power figure-of-merit (PFOM) of 5.98 GW/cm2, which is 2.8 times larger than that of the conventional single-layer JTE structure. These results indicate that the double-layer JTE structure provides a viable way of fabricating high-performance Ga2O3 HJDs.
β-Ga2O3 breakdown voltage heterojunction diode (HJD) junction termination extension (JTE) power figure-of-merit (PFOM) Journal of Semiconductors
2023, 44(7): 072802
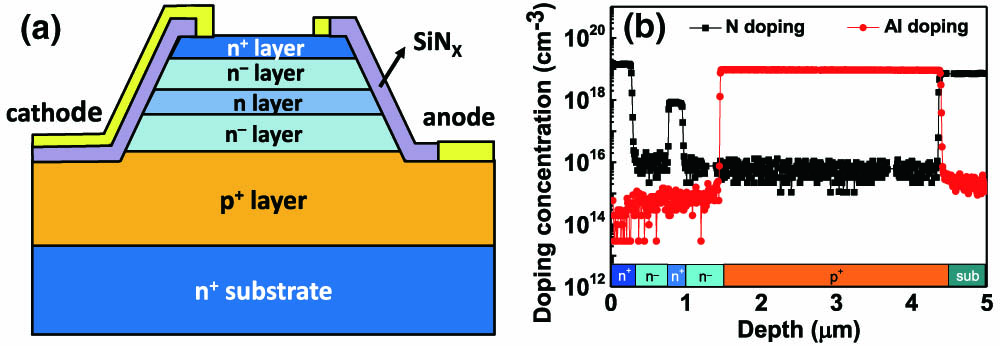
Author Affiliations
Abstract
National Key Laboratory of ASIC, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
In this work, high-stability 4H-SiC avalanche photodiodes (APDs) for ultraviolet (UV) detection at high temperatures are fabricated and investigated. With the temperature increasing from room temperature to 150°C, a very small temperature coefficient of 7.4 mV/°C is achieved for the avalanche breakdown voltage of devices. For the first time, the stability of 4H-SiC APDs is verified based on an accelerated aging test with harsh stress conditions. Three different stress conditions are selected with the temperatures and reverse currents of 175°C/100 µA, 200°C/100 µA, and 200°C/500 µA, respectively. The results show that our 4H-SiC APD exhibits robust high-temperature performance and can even endure more than 120 hours at the harsh aging condition of 200°C/500 µA, which indicates that 4H-SiC APDs are very stable and reliable for applications at high temperatures.
silicon carbide photodiode UV detector high temperature avalanche Geiger mode Chinese Optics Letters
2023, 21(3): 032502

Author Affiliations
Abstract
National Key Laboratory of Application Specific Integrated Circuit (ASIC), Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
Ga2O3 metal–oxide–semiconductor field-effect transistors (MOSFETs) with high-breakdown characteristics were fabricated on a homoepitaxial n-typed β-Ga2O3 film, which was grown by metal organic chemical vapor deposition (MOCVD) on an Fe-doped semi-insulating (010) Ga2O3 substrate. The structure consisted of a 400 nm unintentionally doped (UID) Ga2O3 buffer layer and an 80 nm Si-doped channel layer. A high k HfO2 gate dielectric film formed by atomic layer deposition was employed to reduce the gate leakage. Moreover, a source-connected field plate was introduced to enhance the breakdown characteristics. The drain saturation current density of the fabricated device reached 101 mA/mm at Vgs of 3 V. The off-state current was as low as 7.1 × 10-11 A/mm, and the drain current ION/IOFF ratio reached 109. The transistors exhibited three-terminal off-state breakdown voltages of 450 and 550 V, corresponding to gate-to-drain spacing of 4 and 8 μm, respectively.
Journal of Semiconductors
2019, 40(1): 012803

Author Affiliations
Abstract
National Key Laboratory of ASIC, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
Ultraviolet (UV) detectors with large photosensitive areas are more advantageous in low-level UV detection applications. In this Letter, high-performance 4H-SiC p-i-n avalanche photodiodes (APDs) with large active area (800 μm diameter) are reported. With the optimized epitaxial structure and device fabrication process, a high multiplication gain of 1.4 × 106 is obtained for the devices at room temperature, and the dark current is as low as ~10 pA at low reverse voltages. In addition, record external quantum efficiency of 85.5% at 274 nm is achieved, which is the highest value for the reported SiC APDs. Furthermore, the rejection ratio of UV to visible light reaches about 104. The excellent performance of our devices indicates a tremendous improvement for large-area SiC APD-based UV detectors. Finally, the UV imaging performance of our fabricated 4H-SiC p-i-n APDs is also demonstrated for system-level applications.
040.1345 Avalanche photodiodes (APDs) 040.7190 Ultraviolet 040.6070 Solid state detectors 230.5160 Photodetectors Chinese Optics Letters
2019, 17(9): 090401
Author Affiliations
Abstract
National Key Laboratory of ASIC, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
In this Letter, we report large-area (600 μm diameter) 4H-SiC avalanche photodiodes (APDs) with high gain and low dark current for visible-blind ultraviolet detection. Based on the separate absorption and multiplication structure, 4H-SiC APDs passivated with SiNx instead of SiO2 are demonstrated for the first time, to the best of our knowledge. Benefitting from the SiNx passivation, the surface leakage current is effectively suppressed. At room temperature, high multiplication gain of 6.5×105 and low dark current density of 0.88 μA/cm2 at the gain of 1000 are achieved for our devices, which are comparable to the previously reported small-area SiC APDs.
040.1345 Avalanche photodiodes (APDs) 040.7190 Ultraviolet 040.6070 Solid state detectors Chinese Optics Letters
2018, 16(6): 060401
河北半导体所专用集成电路国家级重点实验室, 河北 石家庄 050051
由于高的电子迁移率和二维电子气浓度, InP基赝配高电子迁移率晶体管(PHEMTs)器件成为制作太赫兹器件最有前途的三端器件之一。为提高器件的工作频率, 采用InAs复合沟道, 使得二维电子气的电子迁移率达到13 000 cm2/(V·s)。成功研制出70 nm栅长的InP基赝配高电子迁移率晶体管, 器件采用双指, 总栅宽为30 μm, 源漏间距为2 μm。为降低器件的寄生电容, 设计T型栅的栅根高度达到210 nm。器件的最大漏端电流为1 440 mA/mm(VGS=0.4 V), 最大峰值跨导为2 230 mS/mm。截止频率fT和最大振荡频率fmax分别为280 GHz和640 GHz。这些性能显示该器件适于毫米波和太赫兹波应用。
InAs沟道 高电子迁移率晶体管 T型栅 最大振荡频率 InAs-channel high electron mobility transistor T shaped gate maximum oscillation frequency 红外与激光工程
2016, 45(7): 0720004





